ICP (SAMCO RIE10iP)
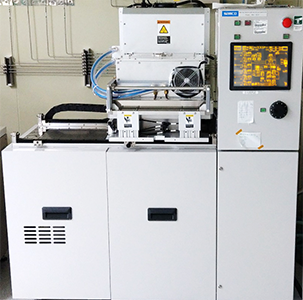
【儀器管理員】游良堃 / forgetk99[at]gmail.com / 02-2789-8354
- 儀器全名:氧化物深蝕刻機 (Inductively Coupled Plasma Reactive Ion Etching System 型號:RIE-10iP)
- 服務簡介:RIE-10iP內建觸控平板,配有Ar, O2, CH4, CHF3, C4F8, SF6六種氣體,可設定參數並儲存以提供全自動操作程序,另亦可全手動操作程序。雙對稱真空抽氣系統提供更即時有效的真空環境,可抽至8 x 10-3 Pa。上滑軌式腔體蓋,搭配氦氣氣冷式樣品座,可更方便擺放樣品。RIE-10iP配有封閉式氣體運輸系統,降低氣體運送的延遲時間,佐以最大達1 KW的龍捲風式RF,可提供更均勻的耦合離子,完成深蝕刻製程。
- 儀器規格:
- Sample size: Max to 4 inch wafer
- Tornado ICP: 1KW (Max)
- Bias power supply: 300W (Max)
- Gas flow: Ar, O2, CH4, CHF3, C4F8, SF6
- 收費標準:
- 尖峰時間 (09:00am-19:00pm):750 NTD/hr
- 離峰時間 (19:00pm-09:00am):500 NTD/hr
- 訓練費及考核費:750 NTD/hr
- 代工費用為使用費2倍
- MODEL: RIE-10iP Inductively Coupled Plasma Reactive Ion Etching System
- Introduction: RIE-10iP provides computerized touch panel as user friendly interface for parameter control and recipe storage, supplying Ar, O2, CH4, CHF3, C4F8, SF6 for the process. Symmetrical evacuation design creates an efficient vacuum flow to 8 x 10-3 Pa in the chamber. Open-load system and helium backside cooling make sample loading easier. Meanwhile, RIE-10iP is equipped close coupled Gas delivery box to reduce the residence time and 1 KW Tornado ICP to achieve uniform plasma etching over the wafer for anisotropic nano-scale structure.
- Spec:
- Sample size: Max to 4 inch wafer
- Tornado ICP: 1KW (Max)
- Bias power supply: 300W (Max)
- Gas flow: Ar, O2, CH4, CHF3, C4F8, SF6
- Chargement:
- Rush Hour (09:00am-19:00pm):1,500 NTD/2hr
- Off-peak (19:00pm-09:00am):1,000 NTD/2hr